近日,美國斯坦福大學研究團隊發現,在計算機芯片中添加金剛石層可以顯著增強熱傳遞,為速度更快、功能更強大的計算機鋪平了道路。
相關研究成果以“Lossless Phonon Transition Through GaN-Diamond and Si-Diamond Interfaces”為題發表于Advanced Electronic Materials期刊。

在眾多超越摩爾定律的方法中,3D 集成電路 (IC) 和采用寬帶隙材料的異質集成 (HI) 是最可行的方法之一。
但由于 3D 集成電路采用堆疊設計,散熱問題更加嚴重。三維設計中增加的功耗和高設備密度會導致溫度升高,從而影響性能和可靠性,這一現象在大功率和高頻應用中更加突出。不管是Si-IC 還是 GaN-PA,都必須在盡可能靠近熱源的地方集成一個散熱器,以便有效地將聲子傳輸到散熱器,而不會破壞器件性能。
為了解決 3D 計算機芯片過熱的問題,斯坦福大學研究團隊設計了新型處理器結構,其中芯片的計算層與金剛石層交錯,通過貫穿芯片所有層的金剛石“通孔”連接,協助器件散熱。
對于 RF 晶體管來說,可以通過用單晶或多晶金剛石(由于其出色的熱導率 300-2200 W m?1 K?1 )替換鈍化層來實現器件級熱管理,而在 Si-IC 中,金剛石可以作為散熱器并入后端制程 (BEOL),如下圖:

雖然金剛石具有高導熱性,但由于金剛石與其他半導體,如 Si、GaN、磷化銦 (InP) 和β氧化鎵 (β-Ga2O3)的晶格和熱膨脹系數 (CTE) 不匹配,因此很難在金剛石與其他半導體之間實現完美界面(外延共價鍵),因此需要在這些半導體與金剛石之間進行界面工程。
該研究團隊曾發現,在金剛石和芯片之間添加一層硅基層可以顯著降低界面熱阻。
“我們發現,設計納米厚度的碳化硅夾層可以顯著改善熱傳遞,因為這些夾層充當橋梁,促進聲子從硅芯片傳輸到金剛石散熱器。”該研究小組發現,最佳層間厚度為 2 至 7 納米,此時傳熱阻力最小。在此厚度下,層間聲子隧穿效應可大大促進傳熱,這是一種量子現象,其中粒子克服了傳統上難以克服或無法克服的障礙。
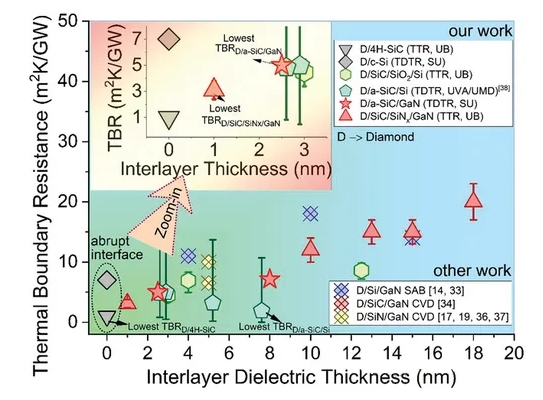
Chowdhury 總結道:“使用薄碳化硅中間層作為熱橋為增強緊湊、密集電子系統的熱管理開辟了新的可能性。此外,我們計劃擴展我們的熱管理解決方案,使5G和6G設備等新興技術受益,旨在提高它們的性能、可靠性和能源效率。”
該團隊預計這些創新將在未來三到五年內融入到商業半導體制造工藝中,為3D計算機發展打開新的思路。


 手機資訊
手機資訊 官方微信
官方微信










 豫公網安備41019702003646號
豫公網安備41019702003646號