摘要 摘要:利用反應磁控濺射技術在純氫等離子體中100~600℃襯底溫度(Ts)下沉積出碳化硅薄膜。紅外吸收光譜和投射電子顯微鏡觀測表明在Ts低至300℃時出現結晶。晶化率隨Ts增大,當...
作者:S. Kerdiles, A. Berthelot, F. Gourbilleau, R. Rizk
摘要:利用反應磁控濺射技術在純氫等離子體中100~600℃襯底溫度(Ts)下沉積出碳化硅薄膜。紅外吸收光譜和投射電子顯微鏡觀測表明在Ts低至300℃時出現結晶。晶化率隨Ts增大,當Ts=600℃時晶化率達到60%。折射率n和室溫下無照導電率σd(RT)隨碳化硅層的結構演變呈較好的一致性。當Ts從100℃增至600℃時,n從1.9增至2.4,σd(RT)改善了6個數量級。
關鍵詞:納米晶碳化硅,低溫沉積,磁控濺射
有研究已經證明在低溫(T<300℃)氫等離子體中可以制備氫化納米晶硅(nc-Si:H),這種硅結構具有優良的電子和光學特性,和非晶副本α-Si:H相比,其導電率高、載流子遷移率有較好改善、有著不同的光吸收。利用準相同實驗方法在較低溫度下可以制備出碳化硅納米晶化;進而制備出碳化硅和硅的氫化納米晶層,最終實現nc-SiC:H/Si:H異質結構。基于這種異質結構的薄膜晶體管能夠將寬帶隙層nc-SiC:H并置至nc-Si:H并減少泄漏電流。此外,nc-SiC:H中相當可觀的載流子遷移率能夠使得電流足夠的大。但目前nc-SiC:H(700℃)沉積工藝中的實際沉積溫度要比nc-Si:H沉積溫度高出許多;因此,nc-Si:H的結構和性能會受到nc-SiC:H沉積的影響。
在接近硅沉積溫度的參數條件下為研究碳化硅沉積過程中可能的結晶化,實驗采用碳和硅的氫反應共濺射法在(100)硅襯底或石英襯底上制備一系列的薄膜。對碳濺射區進行優化以獲得準化學計量碳化硅層。純氫等離子體的能量密度和壓力分別保持在3.1W/cm2和50mTorr,沉積溫度在100℃~600℃之間變化。采用JEOL 200CX顯微鏡,通過TEM觀察利用傅立葉轉換Nicolet750-II光譜儀在400cm-1和4000cm-1之間收集紅外吸收光譜,從而推斷出生長在硅襯底上的碳化硅層結構。利用雙束Perkin-Elmer分光光度計在200-2500nm光譜范圍內進行光傳輸測量。最后在室溫下利用硅襯底上碳化硅薄膜上的Al(2%Si)蒸發電極測量其無照導電率。對-50V~+50V電壓之間的歐姆接觸特性進行檢測。
摘要:利用反應磁控濺射技術在純氫等離子體中100~600℃襯底溫度(Ts)下沉積出碳化硅薄膜。紅外吸收光譜和投射電子顯微鏡觀測表明在Ts低至300℃時出現結晶。晶化率隨Ts增大,當Ts=600℃時晶化率達到60%。折射率n和室溫下無照導電率σd(RT)隨碳化硅層的結構演變呈較好的一致性。當Ts從100℃增至600℃時,n從1.9增至2.4,σd(RT)改善了6個數量級。
關鍵詞:納米晶碳化硅,低溫沉積,磁控濺射
有研究已經證明在低溫(T<300℃)氫等離子體中可以制備氫化納米晶硅(nc-Si:H),這種硅結構具有優良的電子和光學特性,和非晶副本α-Si:H相比,其導電率高、載流子遷移率有較好改善、有著不同的光吸收。利用準相同實驗方法在較低溫度下可以制備出碳化硅納米晶化;進而制備出碳化硅和硅的氫化納米晶層,最終實現nc-SiC:H/Si:H異質結構。基于這種異質結構的薄膜晶體管能夠將寬帶隙層nc-SiC:H并置至nc-Si:H并減少泄漏電流。此外,nc-SiC:H中相當可觀的載流子遷移率能夠使得電流足夠的大。但目前nc-SiC:H(700℃)沉積工藝中的實際沉積溫度要比nc-Si:H沉積溫度高出許多;因此,nc-Si:H的結構和性能會受到nc-SiC:H沉積的影響。
在接近硅沉積溫度的參數條件下為研究碳化硅沉積過程中可能的結晶化,實驗采用碳和硅的氫反應共濺射法在(100)硅襯底或石英襯底上制備一系列的薄膜。對碳濺射區進行優化以獲得準化學計量碳化硅層。純氫等離子體的能量密度和壓力分別保持在3.1W/cm2和50mTorr,沉積溫度在100℃~600℃之間變化。采用JEOL 200CX顯微鏡,通過TEM觀察利用傅立葉轉換Nicolet750-II光譜儀在400cm-1和4000cm-1之間收集紅外吸收光譜,從而推斷出生長在硅襯底上的碳化硅層結構。利用雙束Perkin-Elmer分光光度計在200-2500nm光譜范圍內進行光傳輸測量。最后在室溫下利用硅襯底上碳化硅薄膜上的Al(2%Si)蒸發電極測量其無照導電率。對-50V~+50V電壓之間的歐姆接觸特性進行檢測。
圖一為標記了沉積溫度值的碳化硅層上的紅外光譜。在800cm-1處有顯著吸收帶,由900cm-1處和1000cm-1處的兩條伴線左右相夾。800cm-1處的主光帶是Si-C鍵合(Si-C)s的伸縮振動特征。在濺射薄膜實驗中,可歸因于不受Si-CH3振動模式影響的(Si-C)s模式。Si-CH3振動模式通常出現在利用化學氣相沉積工藝制備出包含有硅烷和碳氫化合物碎片的試樣中。900cm-1處和1000cm-1處的附加結構可能是由于Si-H2彎曲和C-H搖擺所致;特別是它們在2100cm-1處和2900cm-1處各自的伸展方式,如圖1所示。
圖1:帶有襯底溫度指示值的碳化硅層在500-1300cm-1區的紅外吸收光譜;內嵌圖為1900-3300cm-1區兩個典型光譜
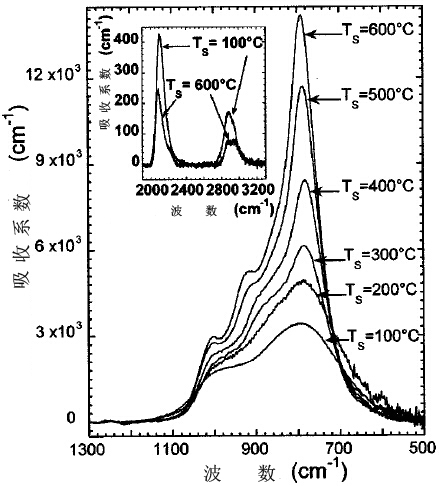
隨著Ts由100℃增至600℃,(Si-C)s峰值被修改,峰值幅度呈系統性增長并伴隨著峰值寬度的持續變窄。光帶形狀逐漸由明顯的Ts=100℃時的純高斯變為Ts=600℃時的洛倫茲線;洛倫茲線可以揭示最小鍵角變形和鍵長散布,并以此來表征晶體材料。對于Ts中間值(200-500℃),實驗利用高斯和洛倫茲線混合來指示既包含非晶形又包含晶體的碳化硅相薄膜。為進一步研究這方面,在分別減去900cm-1處和1000cm-1處Si-H2和C-H振動模式的影響之后,對800cm-1處光帶進行去卷積。圖2為典型的紅外光譜去卷積。(Si-C)s峰值中洛倫茲線的L區部分可以假定為和晶體相中Si-C鍵的數量成比例。利用該步驟最終推斷出晶體尺寸fc,也即圖三中作為沉積溫度函數關系的L/(L+G)比率。
圖2:550-1150cm-1區紅外吸收光譜去卷積

(詳細內容敬請點擊這里)


 手機資訊
手機資訊 官方微信
官方微信







 豫公網安備41019702003646號
豫公網安備41019702003646號