1 異質外延單晶金剛石
微波等離子體化學氣相沉積(MPCVD)是高質量單晶金剛石制備的主流方法。根據襯底選擇可將其分為同質外延和異質外延兩種。同質外延以單晶金剛石為襯底,通過三維生長技術、馬賽克拼接技術來獲得大面積單晶。目前利用馬賽克拼接技術可獲得尺寸為40 mm×60 mm的單晶金剛石襯底。異質外延的外延材料與襯底材料不同,金剛石單晶異質外延技術歷經多年發展,從起初的外延金剛石晶粒,到完整的異質外延單晶金剛石薄膜,如今已能外延生長近4英寸的單晶金剛石襯底(見圖1),晶體質量也在不斷提升。

圖1 當前最大尺寸的異質外延單晶金剛石襯底
MgO和SrTiO3與金剛石的熱膨脹系數差異大,所以當達到適宜金剛石外延的溫度時(圖2中虛線所示),沉積在氧化物襯底上的金剛石薄膜內的高應力會導致金剛石容易碎裂或是從襯底上脫落。Al2O3和Si襯底則具有成本低、可獲得大面積襯底、晶體質量高等優勢,而且與金剛石熱失配相對較小,因而成為了異質外延單晶金剛石的主流襯底。

圖2 不同襯底與沉積的金剛石之間的熱應力-沉積溫度變化關系
如圖3所示,在BEN過程剛開始時,Ir表面首先生成一層非晶碳層(見圖3(a)),在電場加速的作用下,被微波激發的碳離子源源不斷地被注入到Ir的亞表面直至飽和,而當碳的濃度繼續升高時,Ir亞表面的C原子就會析出形成初級金剛石核。初級金剛石核形成之后,通過C原子之間的相互作用力規范其周圍的C原子,形成排列規則的金剛石核(見圖3(c))。而在偏壓關掉后,以及金剛石快速生長過程開始的5~10 s內,Ir表面的非晶碳便會在富氫的環境下被刻蝕掉。

圖3 金剛石BEN過程示意圖
實驗成功制備了尺寸為10 mm×10 mm×1 mm的單晶金剛石襯底,其拉曼半峰全寬為3.7 cm-1,晶體質量較好。
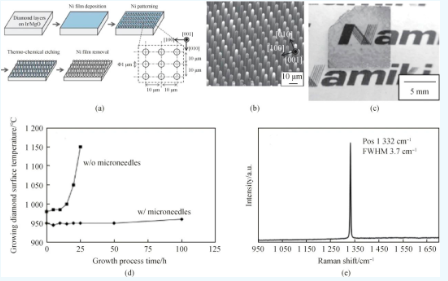
圖4 (a)金剛石微米針制備工藝流程;(b)經 Ni化學刻蝕后形成的金剛石微米針;(c)10 mm×10 mm×1 mm異質外延單晶金剛石襯底;(d)有、無微米針襯底在生長過程中的溫度變化對比;(e)金剛石襯底的拉曼光譜圖
該方法有以下優點:1)利用ELO提高了金剛石晶體質量;2)金剛石微米針可以有效緩解金剛石和氧化物由于晶格失配所產生的應力,解決了快速生長過程中因襯底翹曲而散熱不佳的問題;3)可以實現金剛石與襯底的自動剝離。此方法或可在所得金剛石襯底上進行多次迭代,不斷提高金剛石晶體質量。

圖5 1英寸異質外延金剛石襯底[25]
2022年,Kasu團隊在表面偏<001>方向7°的α-Al2O3襯底上進行金剛石的異質外延生長,其襯底結構如圖6(a)所示。實驗發現,金剛石在快速生長過程中呈臺階生長模式,其晶體內部的張應力被釋放,改善了結晶質量,成功地制備了尺寸2英寸的單晶金剛石襯底(見圖6(b))

圖6 (a)離軸生長示意圖;(b)2英寸異質外延單晶金剛石襯底;(c)2英寸單晶金剛石(004)面的XRD搖擺曲線半峰全寬全譜圖
如圖7所示,加入含有金屬W的緩沖層后,金剛石表面刻蝕坑數量明顯減少,位錯密度大幅降低。

圖7 經H2/O2等離子體處理后的MPCVD異質外延金剛石表面SEM照片
2 基于異質外延單晶金剛石襯底的功率電子器件
金剛石的n型摻雜技術面臨著施主激活能高的問題,其技術還在探索中。目前的金剛石基MOSFET主要是利用氫終端作為導電溝道來制備。氫終端金剛石暴露在空氣、二氧化氮、臭氧,或是和一些過渡屬氧化物如V2O5、MoO3等接觸時,表面電子將會轉移到表面吸附物中,從而引起表面能帶上彎,進而在表面形成一層二維空穴氣(2DHG)。
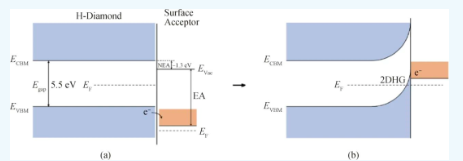
圖8 氫終端金剛石表面形成二維空穴氣的能帶示意圖[59]
器件結構如圖9所示。其最大源漏電流為-288 mA/mm。實驗證明,100 nm Al2O3鈍化層有效地抑制了器件的漏電,關態下實現了-2608 V的擊穿電壓,擊穿電場為2 MV·cm-1,這與目前SiC、GaN基MOSFET相當。
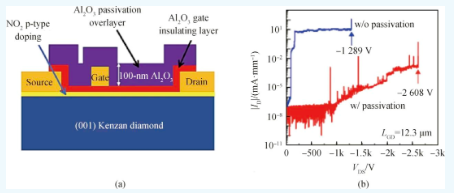
圖9 100 nm Al2O3覆蓋層的MOSFET結構截面示意圖(a)和關態下的ID-VDS(b)
2022年,Kasu等利用化學機械拋光(CMP)技術對異質外延單晶金剛石襯底進行拋光來提高表面平整度和降低缺陷。經過200 h的CMP處理后,金剛石表面粗糙度為0.04 nm,氫終端表面方塊電阻大小為3.55 kΩ/sq,結果如圖10(a)所示。

圖10 (a)不同CMP處理下的金/氫終端金剛石傳輸線模型參數;(b)MOSFET開態下的ID-VDS曲線;(c)有效遷移率;(d)關態下的ID-VDS曲線
同年,該研究團隊制備了“調制摻雜”金剛石MOSFET。如圖11所示,通過在8 nm的Al2O3柵極介質層上方進行二氧化氮摻雜,將NO2和氫終端溝道進行分離,遷移率提高到496 cm2/(V·s),擊穿電壓達到-3326 V,最大漏極電流密度為-0.42 A/mm,BFOM為820.6 MW/cm2,該研究證明了異質外延單晶金剛石有望運用于射頻功率器件。

圖11 (a)MOSFET橫截面結構示意圖;(b)調制摻雜的MOSFET有效遷移率隨載流子濃度的變化
如圖12所示,p-i-n二極管的電流-電壓特性表現出良好的整流特性。增大正向電流導致缺陷發光的積分強度呈亞線性增加,而自由激子發光的積分強度呈超線性增加。這一顯著的趨勢與在傳統的HTHP合成金剛石襯底上用同質外延生長薄膜制備的p-i-n二極管所觀察到的趨勢相同。預示著異質外延單晶金剛石襯底在未來金剛石基電子器件中的潛力。
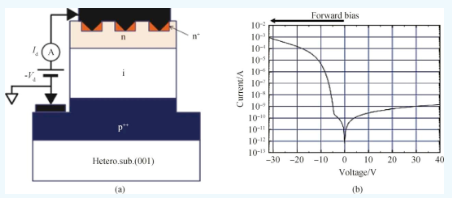
圖12 (a)p-i-n器件結構以及測試原理圖;(b)二極管正向導通特性
由于金剛石的n型摻雜技術尚未成熟,所以目前的金剛石基肖特基二極管主要通過p型金剛石和金屬形成肖特基結實現。從結構上可分為垂直型、準垂直型和橫向型,其結構如圖13所示。

圖13 (a)垂直型肖特基二極管;(b)準垂直型肖特基二極管;(c)橫向型肖特基二極管
2021年,Sittimart等通過插入含有金屬鎢的緩沖層以抑制缺陷。在邊長為5 mm的異質外延晶體上制備了準垂直肖特基勢壘二極管。插入緩沖層后,面內均勻性得到改善,所有肖特基二極管均表現出優異的整流效果,漏電流得到抑制,如圖14所示。

圖14 沒有(a)和有(b)緩沖層的20個肖特基二極管在室溫下的I-V特性
圖15對比了近年來所報道的金剛石肖特基二極管的電學性能。橫坐標為擊穿電壓,縱坐標為比導通電阻。從圖15可以看出,基于異質外延單晶金剛石襯底的肖特基二極管的性能總體上不如同質外延金剛石襯底,這主要是因為目前的異質外延單晶金剛石襯底的晶體質量難以達到同質外延的水平。進一步提升異質外延單晶金剛石晶體質量是提升器件性能的關鍵。

圖15 金剛石肖特基二極管性能對比圖


 手機資訊
手機資訊 官方微信
官方微信










 豫公網安備41019702003646號
豫公網安備41019702003646號